All Phoenixolar Equipment is 100% Self-developed In-house.
Product Dimensions & Our Equipment
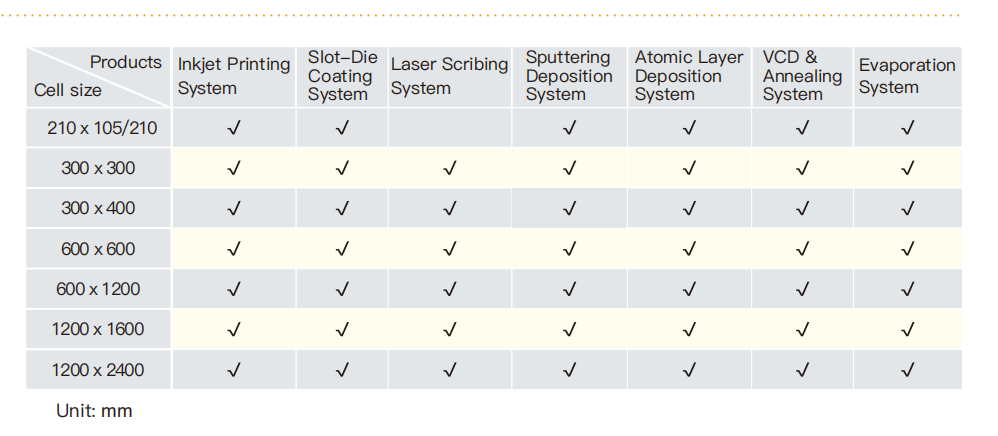
◎ Inkjet Printing System

Features
· Printing speed up to 2, 500 wafer/ hour
· Recirculating ink supply system
· Automatic Purging and cleaning system
· Precise ink deposition on designated areas, with full thin-film coverage on silicon substrates
· Droplet control technology enabling nanometer-level film thickness regulation
· Compatible with multiple substrate sizes
· Fully automated printhead maintenance station
· Process can be directly scaled up for mass production
· High-speed, high -resolution CCD alignment system
Technical Parameters
Printing Speed Control Range
Film Thickness Non-uniformity
Printing Mode
Printing Resolution
Print System Lifting Height
Printhead Height Repeatability
Platform Flatness
10 – 800 mm/s
≤5%
Unidirectional ONEPASS Printing
600 × 600 dpi or 1200 × 600 dpi
50 mm
± 5 µm
± 5 µm
◎ Slot-Die Coating System

Features
· Multi – segment liquid supply for high uniformity of coating layer
· Rapid automatic blade positioning and anti-collision through three laser sensors
· Equipped with high-precision liquid injection pump
· Equipment acceptance test with Perovskite solvent
Technical Parameters
Coating Speed
Coating Speed Control Precision
Dry Film Thickness Non-uniformity
Dry Film Thickness Non-uniformity
Injection Speed
Injection Precision
≥50 mm/s
≤0.1 mm/s
≤5%
≤5%
0.2 – 1000 μL/s
0.1 μL
◎ VCD & Annealing System
-1024x554.jpg)
Features
· Integrated Vacuum Chamber Dryer and annealing processes with a highly controllable film-forming system
· Homogeneous heating of large-area samples ensuring consistent phase transition
· Quickly removed residual solvents in wet films with homogeneous supersaturation
· Variable frequency speed-regulated Roots pump for controllable pumping speed
Technical Parameters
Average Temperature Non-uniformity
10 Second Vacuum Level
±3%
≤ 10 Pa
◎ Laser Scribing System

Features
· P1, P2, P3 femtosecond and picosecond infrared lasers are optional
· Highly customizable, with scribing on film or glass surfaces optional, Top-hat optional
· High precision, capable of line-by-line functionality with small line spacing
· Mature process, smooth edges, no volcano rings or burrs
Technical Parameters
Numbers of Light Paths
Scribing Precision
Maximum Scribing Speed
Scribing Line Width
Edge Cleaning Width
Dust Removal Precision
Dead Zone Control GFF
Dead Zone Width
8 – 24
±5 µm
≥2 m/s
15 -50 µm
≤40 mm
≥0.3 µm
≥95%
<150 µm
◎ Evaporation System

Features
· Multi-source co-deposition for large-area coating
· Precise thermal field and temperature control
Technical Parameters
Film Thickness Non-uniformity
Deposition Speed Stability
Temperature Control Precision
Temperature Fluctuation
Width
≤5% (within wafer, wafer-to-wafer, batch-to-batch)
≤±0.5%
±1%
±2 °C
600 mm
◎ Atomic Layer Deposition System

Features
· Precise control of film thickness
· High film uniformity
· High temperature control precision
· Fully autonomous process chamber design, with the spatial and the temporal optional, multi-wafer and single-wafer optional
Technical Parameters
Film Thickness
Film Thickness Non-Uniformity
Process Temperature
Temperature Control Precision
Overall Temperature Uniformity
1 – 20 nm
≤5%
80 – 120 °C
±1 °C (within wafer, wafer-to-wafer, batch-to-batch)
±2.5 °C
◎ Sputtering Deposition System

Features
· High process stability
· Stable NiOx metal reactive sputtering process
· Cylindrical ITO/NiOx target for high material utilization
· Adjustable target-to-substrate distance for low-damage TCO conductive film deposition
Technical Parameters
ITO Film Coating Thickness Non-uniformity
ITO Film Sheet Resistance
ITO Film Average Visible Light Transmittance (400 – 900 nm)
ITO Film Average Visible Light Transmittance Non-uniformity
NiOx Film Coating Thickness Non-uniformity
NiOx Film Average Visible Light Transmittance Non-uniformity
Large-area Cell Sputtering Process Repeatability
Cylindrical Target Utilization Rate
≤5% @ 100 nm
≤50 Ω/□ @ 100 nm
≥80% @ 100 nm (including ultra-clear glass substrate)
≤5% @ 100 nm
≤5% @ 100 nm
≤5% @ 20 nm
≥95%
≥80%
Perovskite Solar cell Equipment & Process Inquiry
Scheduling An Appointment
© 2025 Phoenixolar. All rights reserved.
